 ПОЗНАВАТЕЛЬНОЕ Сила воли ведет к действию, а позитивные действия формируют позитивное отношение Как определить диапазон голоса - ваш вокал Игровые автоматы с быстрым выводом Как самому избавиться от обидчивости Противоречивые взгляды на качества, присущие мужчинам Вкуснейший "Салат из свеклы с чесноком" Натюрморт и его изобразительные возможности Применение, как принимать мумие? Мумие для волос, лица, при переломах, при кровотечении и т.д. Как научиться брать на себя ответственность Зачем нужны границы в отношениях с детьми? Световозвращающие элементы на детской одежде Как победить свой возраст? Восемь уникальных способов, которые помогут достичь долголетия Классификация ожирения по ИМТ (ВОЗ) Глава 3. Завет мужчины с женщиной Оси и плоскости тела человека - Тело человека состоит из определенных топографических частей и участков, в которых расположены органы, мышцы, сосуды, нервы и т.д.
| Оценка скорости и равномерности осаждения пленок.
Лабораторная работа №2. Электронно-лучевое напыление пленочных покрытий. Цель работы: 1. Ознакомление с особенностями оборудования для электронно-лучевого напыления пленочных покрытий. 2. Ознакомление с устройством и принципами работы электронно-лучевых испарителей. 3. Освоение методики расчета скорости и равномерности осаждения пленок. 4. Освоение методики упрощенного расчета электронно-лучевого нагрева поверхности мишени в зоне облучения. Продолжительность работы – 4 часа. Теоретические сведения. В современной технологии изготовления микроструктур, а также в их исследовании важную роль играют методы, основанные на взаимодействии сфокусированных пучков частиц с поверхностью твердого тела. В большинстве случаев результатом такого взаимодействия является нагрев поверхности в зоне облучения. К наиболее распространенным видам лучевого энергетического воздействия можно отнести лазерную, электронно- и ионнолучевую обработку. Каждый из указанных методов имеет свои особенности, достоинства и недостатки. Общими преимуществами лучевого нагрева по сравнению с традиционными методами являются: - возможность локализации нагрева; - анизотропность воздействия; - малая инерционность переходных тепловых процессов; - возможность как непрерывной, так и импульсной обработки. Концентрация энергии в электронно-лучевых нагревательных устройствах может достигать Оборудование для электронно-лучевого напыления пленок. Любая технологическая установка для нанесения пленок в вакууме состоит из следующих функциональных блоков (см рис.1а): блока осаждения; вакуумной системы; блока питания; системы автоматического управления. В свою очередь, блок осаждения, как правило, включает в себя (см. рис.1б): испарительную систему; вакуумную камеру; устройство крепления подложек; устройство нагрева подложек (нагреватель); вспомогательные устройства (датчики контроля скорости осаждения или толщины пленок, заслонки, устройства механического перемещения камеры, вращения подложкодержателя; натекатели для напуска атмосферы в камеру и т.д.) Основные этапы процесса нанесения пленки: - образование атомарного потока вещества из испарителя; - доставка атомов от испарителя к подложке; - конденсация на подложке. Основные параметры процесса: - температура подложки - определяет адгезию и структуру слоев; - температура и рабочая площадь испарителя - определяют скорость нанесения, структуру и чистоту слоев; - расстояние от испарителя до подложки - определяет скорость нанесения и качество слоев; - остаточное давление - определяет чистоту и свойства слоев. Последовательность проведения процесса; 1.Загрузка испарителя, установка пластин и герметизация камеры; 2. Откачка вакуумной камеры до рабочего давления;
Рис. 1 Установка для напыления пленок в вакууме. а) Блок-схема. б) Блок осаждения пленок. 1. Корпус. 2. Подогреватель подложки. 3. Подложка. 4. Держатель. 5. Напуск атмосферы. 6. Заслонка. 7. Испаряемый материал. 8. Испаритель. 9. Герметизирующая прокладка.
3. Испарение на заслонку, во время которого удаляются загрязнения с поверхности испарителя и испаряемого материала, а напыленная на заслонку пленка поглощает примеси из остаточной атмосферы вакуумной камеры (процесс геттерирования примесей); 4. Напыление (открывание заслонки на определенное время). Выбор испарителя определяется свойствами испаряемого материала, требованиями к толщине, чистоте пленки, а также требованиями к границе раздела пленка-подложка. При очень высокой скорости испарения над испарителем образуется облако пара и микрокапель. При этом условия формирования пленки и ее свойства резко ухудшаются. Оценка скорости и равномерности осаждения пленок. Интенсивность испарения металла из расплава оценивают с использованием уравнения Герца-Кнудсена:
где N - число молекул, испаряющихся с единицы площади в единицу времени; m - молекулярная (атомная) масса испаряемого вещества; k - постоянная Больцмана; Т - температура поверхности источника.(К); P - равновесное парциальное давление пара испаряемого вещества. Величина P может быть выражена через скорость потери источником массы с единицы площади:
где М - масса грамм-моля испаряемого вещества; Суммарная скорость потери массы источником RT в единицу времени может быть определена интегрированием R по площади источника
Рис.2. Параметры, обеспечивающие равномерность толщины покрытия. Если q - угол между нормалью к поверхности подложки и направлением к источнику, то
где D - скорость осаждения (г/см2с). Скорость осаждения в различных точках поверхности подложки над точечным или протяженным источником может быть определена из уравнения (1). Например, для источника с малой площадью
и для источника точечного типа
где D0 - скорость осаждения непосредственно над источником на расстоянии Н от его поверхности; D - скорость осаждения на расстоянии L от центра подложки. Когда источник и подложка расположены на поверхности сферы радиусом r0 (см. рис.2),то
и уравнение (1) примет вид
Следовательно, скорость осаждения в этом случае одинакова во всех точках сферической поверхности, которая расположена за планетарной системой подложкодержателя. В качестве такой системы обычно используют вращающиеся сферические сегменты со сложным механическим приводом. |


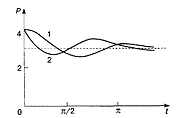
 . В зоне обработки можно получать температуры вплоть до 6000 К. Возможность гибкого управления энергетическими и геометрическими характеристиками электронного луча позволяет использовать этот метод для пайки, резки, прошивки, сварки, напыления пленок самых различных материалов, в том числе тугоплавких.
. В зоне обработки можно получать температуры вплоть до 6000 К. Возможность гибкого управления энергетическими и геометрическими характеристиками электронного луча позволяет использовать этот метод для пайки, резки, прошивки, сварки, напыления пленок самых различных материалов, в том числе тугоплавких.




 Поток материала, наносимого на подложку, зависит от угла f между нормалью к поверхности источника и направлением к поверхности подложки, расположенной на расстоянии r от источника.
Поток материала, наносимого на подложку, зависит от угла f между нормалью к поверхности источника и направлением к поверхности подложки, расположенной на расстоянии r от источника.



